近日,浦口经济开发区企业芯德半导体传来捷报,其自主研发的FOCT-L埋入式桥接扇出式高性能芯片互联封装工艺,成功完成全流程技术验证。这一成果标志着芯德半导体在2.5D/3D先进封装领域取得里程碑式突破,更意味着企业具备国际领先的本地化硅中介层互联集成能力,正式跻身全球先进封装技术第一梯队,为下一代高性能计算芯片提供核心封装支撑。
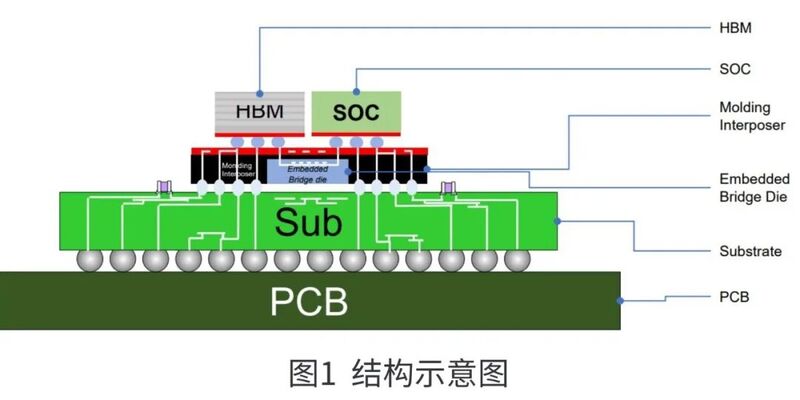
此次芯德半导体研发团队聚焦行业痛点,直面本地硅桥互联、高精度键合、超薄芯片堆叠、信号完整性控制等挑战,实现多芯片模块内局部区域的高密度互连,通过微米级硅桥(Si-Bridge)在芯片边缘关键区域构建微米级互连通道,互连密度较传统封装提升5倍以上,信号传输距离缩短至毫米级。
以本地硅桥(LSI)阵列替代单片硅中介层,实现“化整为零”的模块化设计:单中介层集成2*LSI芯片,支持2500mm²超大封装面积,塑封通孔(TMV)插入损耗<0.3dB/mm,解决光刻拼接误差难题,为国产超大算力芯片扫除封装障碍。


作为2.5D/3D先进封装领域的核心技术,FOCT-L技术凭借高密度、高带宽、低功耗等优势,正成为支撑AI训练芯片、高端GPU、HPC处理器及大容量存储芯片的“基石”。此次2.5D FOCT-L样品成功通线,既是企业技术研发实力的硬核印证,也是高端半导体封装领域迈向自主可控新阶段的关键一步,更是浦口经济开发区推动“四大行动”、培育集成电路产业生态的生动实践。
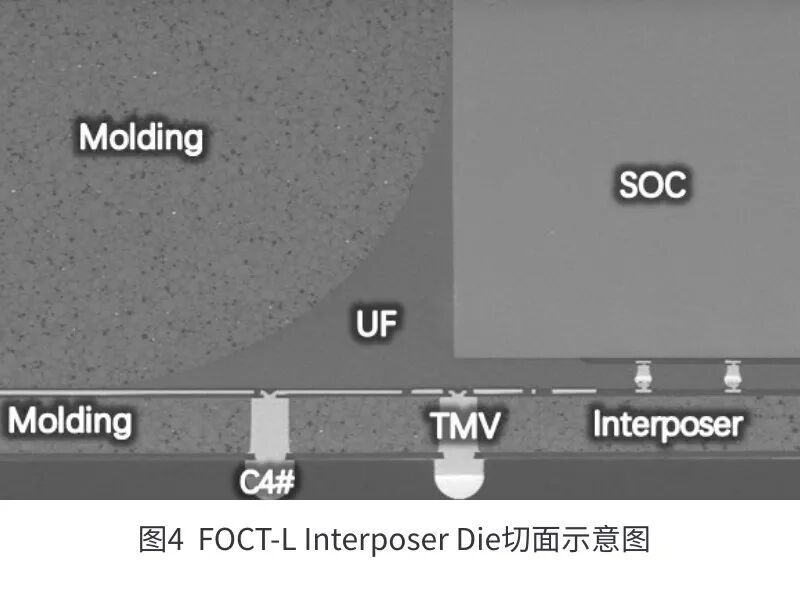
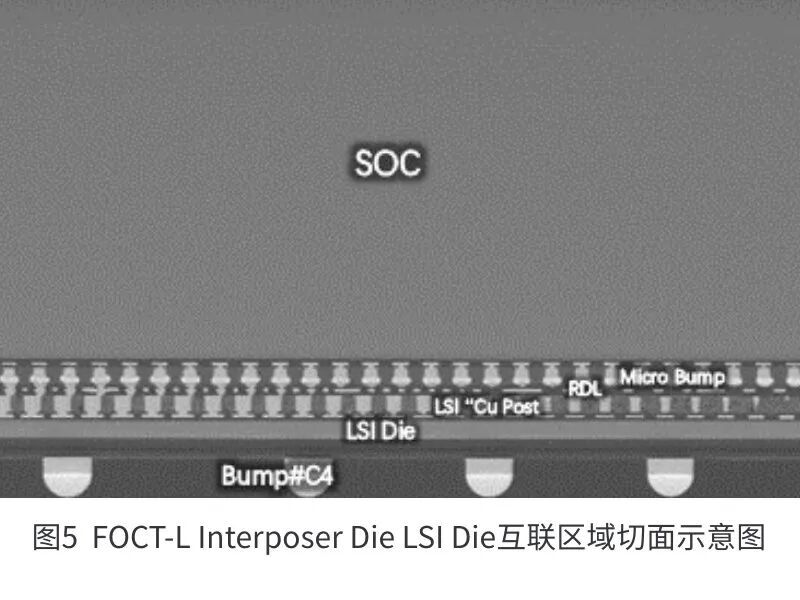
下一步,浦口经济开发区将持续以“四大行动”为引擎,以产业需求为导向,为企业研发与成果转化提供全链条服务,构建创新生态圈,推动科技创新从“单点突破”向“系统提升”跃升。
通讯员:郑仁江、杨长松







 新华报业网
新华报业网














 Android版
Android版
 iPhone版
iPhone版




